IT之家 2 月 21 日消息,分析师 @jukan05 今日转发了一份关于英特尔 Panther Lake 的深度技术分析报告,揭示了首款基于 Intel 18A 制程工艺的 CPU 产品的关键设计参数。

这份报告通过对芯片物理实现的详细拆解,呈现了 18A 工艺在初期量产阶段的真实技术面貌,同时也勾勒出英特尔未来 14A 工艺的技术演进路径。IT之家下面就带大家来看一下。
核心尺寸与单元设计
Panther Lake 芯片的裸晶圆尺寸(Die size)约为 110mm²,芯片内所有区域,包括逻辑芯片和 SRAM 芯片,均采用了高性能(HP)库,而非通常用于提高密度的高密度(HD)库。
具体而言,逻辑芯片部分采用 G50H180 规格,SRAM 芯片面积为 0.023μm²,这与英特尔此前披露的信息一致。
在金属层间距上,其最小金属间距(M0)为 36nm。尽管 Intel 18A 宣称可实现 32nm 的 M0 间距,但这仅适用于 HD 库(对应 H160)。
与业界常见的 HD / HP 同间距但晶体管数量不同的做法不同,18A 的 HD 和 HP 库均维持 5 个鳍片,但 HD 库采用 32nm 间距,而 HP 库则为 36nm 间距。
在金属层方面,前端(FS)共有 15 层金属层,后端(BS)共有 6 层金属层,其中 BM5 层实质上可视为 RDL(重分布层)。
GAA 间距与背面供电的妥协
GAA 全环绕栅极晶体管的间距是衡量工艺先进性的关键指标。Panther Lake 的逻辑最小栅极间距为 76nm,而 SRAM 位线间距为 52nm,两者之间存在显著差异。这一差异背后则是技术的权衡取舍。
关于 Power Via 背面供电技术,英特尔此前已说明 18A 的 SRAM 并未采用 Power Via 方案。18A 的 Power Via 技术是在 GAA 结构之间插入电源通孔,将背面供电连接至前端中段金属层(MEOL)接触层,并向源极提供电力。但是,这要求 GAA 间距必须足够大,否则 Power Via 无法通过。
按照业内普遍认知,若要在 SRAM 单元中实现 Power Via,仅插入 NN 间距一项就需将单元高度增加 1.1 倍。报告指出,虽然英特尔官方解释是背面供电对 SRAM 提供的收益不明显,但根本原因其实在于技术限制。
好消息是,这一限制有望在 14A 节点得到解决。14A 将改用 BSCON 技术,直接从背面连接到晶体管的源极端子,从而摆脱 GAA 间距的约束。这意味着,14A 的 SRAM 是具备采用 Power Via 技术能力的。

在材料层面,18A 的 MEOL(中段制程)接触孔以及 BEOL(后段制程)的 V0/V1 层仍采用钨,而非此前传闻中的钼。M0 金属层则采用铜。分析认为,英特尔计划在 14A 节点引入钼,但 14A 的 M0 间距仍然较大,仅略小于 18A,因此目前尚无必要采用钌。
除此之外,18A 的 GAA 结构已配备内部间隔层(Inner Spacer)。相比之下,三星的 SF3 工艺直到 SF2 节点才引入该结构,这凸显了不同代工厂在技术成熟度上的差异。
在产能与良率方面,报告提到,Panther Lake 目前仍处于良率爬坡阶段,且当前产品全部采用相对更易制造的 HP 库。分析认为,先不考虑英特尔承诺的 32nm 间距,仅从当前量产产品来看,即使在 36nm 上,良率稳定仍需一些时日。
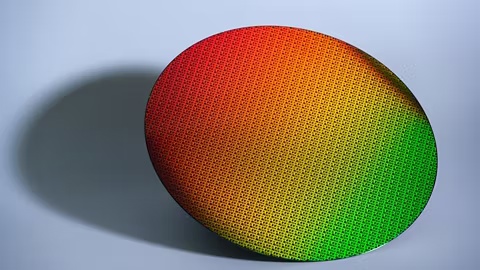
报告提到,18A 逻辑 GAA 间距达 76nm,甚至远大于中芯国际 N+3 工艺的 32nm 鳍片间距。这印证了一个观点:GAA 工艺本身与光刻设备的关联度有限,甚至在光刻设备受限时,反而可通过 GAA 来放宽间距要求。然而,即便拥有这种便利,英特尔要想实现稳定的量产工艺仍非易事。半导体的难度远不止于光刻机,极紫外光刻仅是入场券,真正的竞争在于蚀刻、沉积、清洗等更难的工艺整合能力,而这正是台积电领先于英特尔和三星的核心领域。
相关新闻
关键词:英特尔- 英特尔 Bartlett Lake-S 系列处理器阵容曝光:全大核、睿频最高 5.9GHz,普通消费者无缘
- 英特尔上线 AI 客服 Ask Intel:秒回保修等信息,搞不定转接人工坐席
- 英伟达持股曝光,看黄仁勋AI布局
- 英特尔预测日本 AI PC 渗透率 2026 年将突破 50%
- 英特尔确认 GPU 发布进入“年更”时代:今年推 Xe3P,明年推 Xe-Next
- 消息称 52 核英特尔 Nova Lake 旗舰处理器 PL2 功耗约 350W,2029 年 Titan Lake 搭载英伟达 GPU、Arc 逐渐走向边缘化
- Tower高塔半导体:英特尔有意终止双方晶圆代工制造合作
- JPR 报告 2025Q4 全球服务器 CPU 市场:AMD 份额 28.8%、英特尔 71%





