IT之家 4 月 30 日消息,英特尔新任 CEO 陈立武今日在美国加州圣何塞举行的 Intel Foundry Direct Connect 2025 活动中亮相,概述了公司在晶圆厂代工项目上的进展。

陈立武宣布,公司现在正在与即将推出的 14A 工艺节点(1.4nm 等效)的主要客户进行接触,这是 18A 工艺节点的后续一代。

英特尔已有几个客户计划流片 14A 测试芯片,这些芯片现在配备了公司增强版的背面电源传输技术,称为 PowerDirect。
如果一切按计划进行,14A 将成为行业首个采用 High-NA EUV 光刻技术的节点。台积电的 A14 竞争对手节点预计将在 2028 年到来,但预计不会在生产中使用 High-NA 技术。
陈立武还透露,公司的关键 18A 节点现在处于风险生产阶段,预计今年晚些时候将开始量产。

英特尔还透露其新的 18A-P(IT之家注:18A 节点的性能版本)现在正在晶圆厂中运行,早期晶圆也已投产。
此外,英特尔官宣正在开发新的 18A-PT 版本,该版本支持 Foveros Direct 3D,采用混合键合互连,使英特尔能够在其最先进的领先节点上垂直堆叠晶圆。
Foveros Direct 3D 技术是一个关键的发展,因为它提供了一种竞争对手台积电已在生产中使用的功能,最著名的是 AMD 的 3D V-Cache 产品。事实上,英特尔在关键互连密度测量方面的实现与台积电的产品相匹配。
在成熟的节点方面,英特尔晶圆厂现在有了首个 16nm 量产晶圆,该公司现在也在与联电合作开发 12nm 节点。
根据英特尔的官方路线图,18A-P 将在 2026 年推出,18A-PT 要等到 2028 年。此外,14A 将在 2027 年到来,还会有 14A-E 工艺。
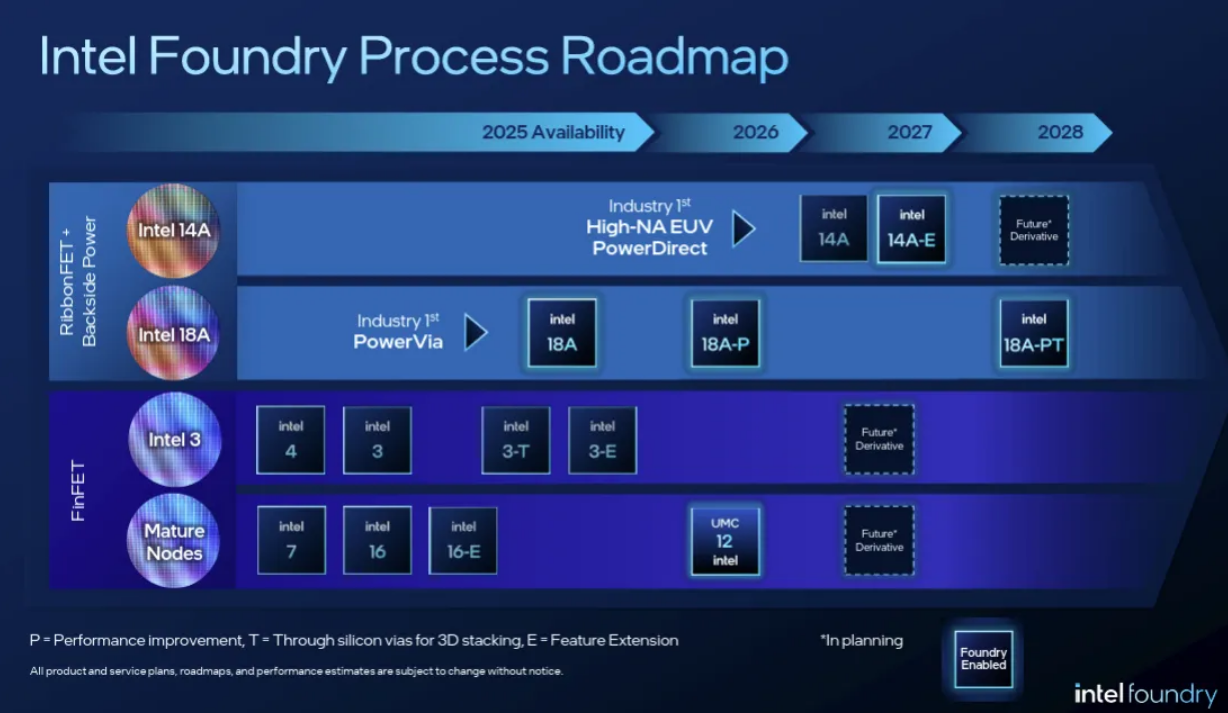
针对先进封装需求,英特尔代工提供系统级集成服务,使用 Intel 14A 和 Intel 18A-P 制程节点,通过 Foveros Direct(3D 堆叠)和 EMIB(2.5D 桥接)技术实现连接。
英特尔还将向客户提供新的先进封装技术,包括面向未来高带宽内存需求的 EMIB-T;在 Foveros 3D 先进封装技术方面,Foveros-R 和 Foveros-B 也将为客户提供更多高效灵活的选择。
制造方面,英特尔亚利桑那州的 Fab 52 晶圆厂成功“全流程运行”,标志着通过该设施加工了第一块晶圆。英特尔 18A 的大规模生产将在俄勒冈州的英特尔工厂开始,而亚利桑那州的制造将在今年晚些时候扩大。



