
(图片来源:Tom's Hardware)
在加利福尼亚州圣何塞举办的英特尔代工直连2025活动中,新任首席执行官帕特·基辛格发表演讲,概述了公司在代工业务方面的最新进展。基辛格宣布,英特尔正积极与主要客户沟通即将推出的14A工艺节点(相当于1.4纳米),作为18A节点的后续产品。目前,已有几位客户计划使用配备增强版背面电源传输技术(PowerDirect)的14A测试芯片。此外,18A节点已进入风险生产阶段,预计今年晚些时候将开始批量生产。
英特尔还透露,其18A-P扩展版(高性能变体)已开始早期晶圆生产,而新开发的18A-PT变体则支持通过混合键合互连的Foveros Direct 3D技术,实现了在领先节点上的芯片垂直堆叠。这项技术对于保持与竞争对手台积电(已在AMD的3D V-Cache产品中应用)的竞争力至关重要,且英特尔在关键互连密度方面与台积电相匹敌。
在成熟节点方面,英特尔代工业务已有首批16纳米晶圆投入生产,并与联合微电子中心合作开发12纳米节点,现正积极接洽相关客户。
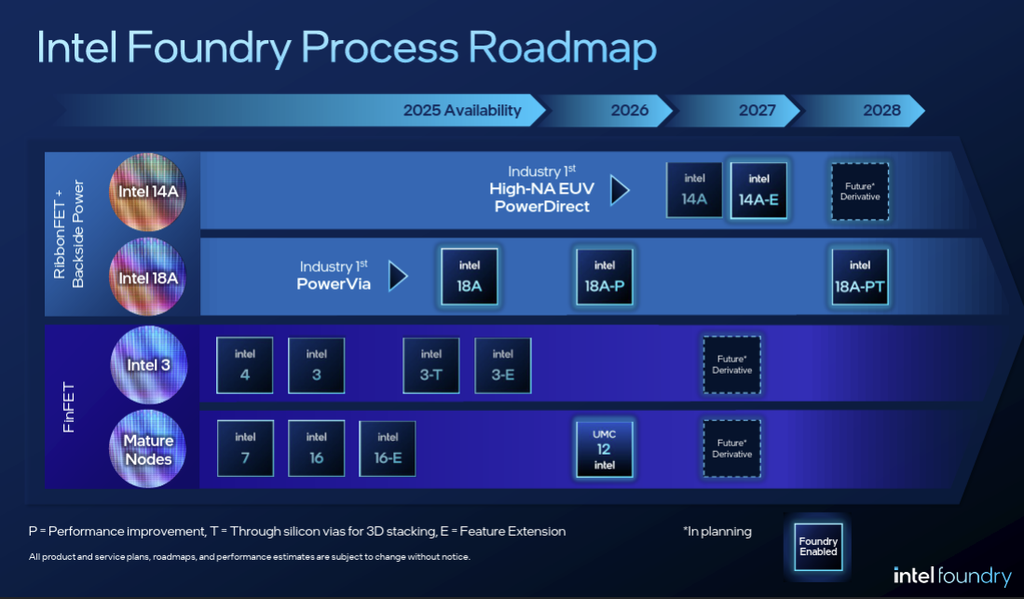
(图片来源:Tom's Hardware)
本次活动的另一大亮点是英特尔与EDA和知识产权(IP)合作伙伴的深化合作,这些合作伙伴提供关键工具和IP模块,助力客户采用行业标准设计流程和工具开发新设计。英特尔还扩展了代工加速器联盟计划,涵盖Chiplet联盟和价值链联盟。
在全球半导体行业动荡、地缘政治分裂威胁全球芯片供应链的背景下,英特尔作为唯一一家基于美国的领先工艺节点技术和先进封装能力的国内供应商,其优势愈发凸显。尽管台积电在美国有所扩张,但台湾新法律限制了其在美国生产最先进技术,使英特尔成为唯一同时拥有领先芯片生产和研发的国内代工厂。
英特尔代工业务的首席技术和运营官纳加·钱德拉塞卡兰及代工服务总经理凯文·奥巴克利也将在活动中发表演讲,详细介绍技术和路线图。随着信息的不断公布,我们将持续更新本文内容,与读者分享英特尔的最新进展。
英特尔14A工艺节点
英特尔14A工艺节点:迈向更先进的制程
作为18A的下一代产品,英特尔14A工艺节点目前正处于开发阶段,尚未公布确切时间表。若一切顺利,14A将成为首个采用高数值孔径EUV光刻技术的节点,而台积电的A14节点预计将于2028年推出,但不涉及高数值孔径技术。
英特尔已与主要客户分享了14A的早期工艺设计套件(PDK),多个客户已表达使用14A节点构建芯片的意愿。14A将采用第二代PowerVia背面电源传输技术——PowerDirect,通过专用触点直接将电源输送到每个晶体管的源极和漏极,提升电源效率。
英特尔18A-PT工艺节点:支持芯片堆叠的创新
英特尔18A-PT工艺节点:开创3D芯片堆叠新纪元
英特尔的18A节点不仅包含主流变体,还有多个针对不同用例定制的“线扩展”版本。其中,18A-PT节点在保持与18A-P相同性能和效率优势的同时,增加了Foveros Direct 3D混合键合技术,实现无凸点铜对铜键合,间距小于5微米,显著提升芯片堆叠密度。
值得注意的是,AMD采用台积电的SoIC-X技术以9微米凸点间距融合L3小芯片与X3D处理器,而台积电SOIC-X技术目前间距范围在4.5至9微米之间,计划于2027年实现3微米间距。若英特尔的Foveros Direct 3D技术按计划实现,将在封装技术领域占据显著优势。
英特尔18A工艺节点更新:迈向量产
英特尔18A工艺节点:量产在即

(图片来源:Tom's Hardware)
英特尔18A工艺节点已进入风险生产阶段,标志着首批低产量生产运行的开始,批量生产计划于今年年底进行。首批18A产品将源自俄勒冈州工厂,同时亚利桑那州工厂也已“运行了[18A]批次”,预示着即将在该地启动生产。
18A节点作为首个同时采用PowerVia背面电源传输网络和RibbonFET环绕栅极晶体管的产品化节点,在性能、晶体管密度和功耗方面均表现出色。与台积电的2纳米N2节点相比,18A节点在速度和功耗上更具优势,尽管台积电在密度方面保持领先。
成熟节点:16纳米与12纳米的持续推进
成熟节点:稳步前行的16纳米与12纳米
英特尔代工业务不仅聚焦于前沿技术,还在积极开发多个成熟节点。16纳米节点作为22FFL节点的优化版,现已投入生产。同时,与联合微电子中心合作的12纳米节点将于2027年在亚利桑那州工厂启动生产,主要应用于移动通信基础设施和网络领域。
当前主要成果与展望
当前主要成果与未来展望
尽管英特尔取消了20A节点的大批量生产以降低成本,但18A节点的量产标志着其在重夺台积电制造领先地位方面迈出了重要一步。18A-PT变体在芯片堆叠方面的显著进展将进一步增强对潜在代工客户的吸引力。
英特尔14A节点的顺利开发表明公司正按计划推进路线图。尽管尚未透露关于10A(1纳米级)节点的新细节,但预计将于2027年开始开发。此外,英特尔在活动中重点展示了其广泛的EDA、IP和服务组合,以及新的Chiplet联盟,为客户提供了更多设计灵活性。
英特尔的先进封装服务同样重要,它们为实现有意义的收入提供了最快途径。英特尔已宣布向代工客户提供3D堆叠Foveros实施,并与Amkor建立新合作伙伴关系。随着更多信息的公布,我们将持续更新本文内容。



