HBM4 时代内存巨头加速混合键合技术导入,产品最快明年亮相
11 小时前
/ 阅读约1分钟
来源:IT之家
三星电子预计最早将于明年的 HBM4 内存中采用混合键合,而 SK 海力士可能会在稍晚的 HBM4E 中导入。
IT之家 5 月 8 日消息,韩媒《朝鲜日报》在当地时间昨日的报道中表示,两大韩系 DRAM 内存原厂三星电子和 SK 海力士都正在考虑将混合键合技术引入下一代 HBM 内存 —— HBM4 中。
消息人士透露,三星电子预计最早将于明年的 HBM4 内存中采用混合键合,而 SK 海力士可能会在稍晚的 HBM4E 中导入;美光和其它企业则计划考虑导入有凸块键合的迭代版本:无助焊剂键合。
相较于现有 HBM 内存使用的有凸块键合,无凸块的混合键合有利于降低 HBM 内存堆栈的层高,支持更多堆叠层数,同时其也具备电气性能上的优势,可实现更出色的传输速率。
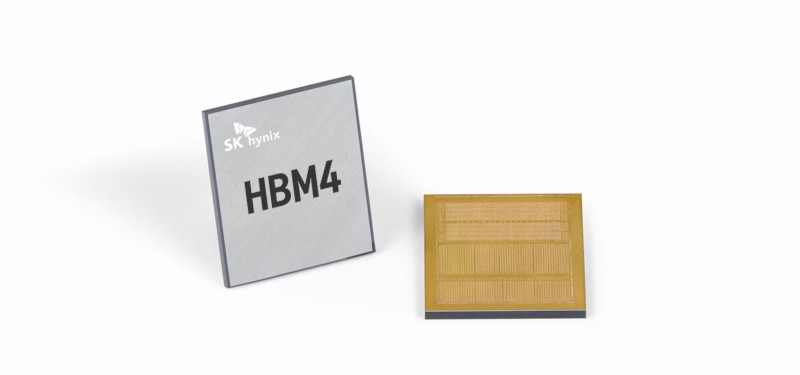
IT之家注意到,半导体设备厂商 Besi 在其今年 4 月公布的年报文件中表示,采用混合键合技术的 HBM 内存虽然会较此前预期晚一年,但仍会在 2026 年以 16Hi HBM4 (E) 的形式面世。




